
儅僀僋儘僐僱僋僞偺尋媶奐敪 |
仭 嵟愭抂敿摫懱IC媄弍偺敪揥偵傛傝SOC乮僔僗僥儉丒僆儞丒僠僢僾乯偲屇偽傟傞崅婡擻LSI偑惢憿壜擻偵側傝丄偦傟傪梡偄偨彫宆丒寉検丒崅婡擻揹巕憰抲偑奐敪偝傟偰偄傞丅偦傟偵敽偄憰抲撪偵巊梡偝傟傞愙懕梡僐僱僋僞傕峏側傞彫宆壔偑梫媮偝傟偰偄傞丅杮尋媶偱偼岤枌儗僕僗僩傪梡偄偨UV僼僅僩儕僜僌儔僼傿偲旝嵶揹拻媄弍傪慻傒崌傢偣傞偙偲偵傛傝僺僢僠80兪倣偺儅僀僋儘僐僱僋僞偺惢嶌傪峴偭偨
仭
廬棃昳偲斾妑偟偨応崌丄婛懚偺僐僱僋僞偼丄僾儗僗壛岺丒幩弌惉宍偱惢嶌偟偰偄傞偨傔僺僢僠300兪倣埲壓偺壛岺偑崲擄偱偁傞丅岤枌儗僕僗僩傪梡偄偨UV僼僅僩儕僜僌儔僼傿偲旝嵶揹拻媄弍傪慻傒崌傢偣傞偙偲偵傛傝僺僢僠80兪倣偺儅僀僋儘僐僱僋僞偺惢嶌傪栚昗偲偟偨乮Table.1乯丅
仭 SiO2晅偒偺Si婎斅傪梡偄傞丅偦偺忋偵媇惖憌偍傛傃僐僱僋僞愙揰偺揹拻梡庬憌偲偟偰Cr/Ni傪恀嬻忲拝偵傛傝宍惉偡傞丅僼僅僩儕僜僌儔僼傿偵傛傝媇惖憌偺僷僞乕僯儞僌傪峴偄丄Cu傪揹拻偟媇惖憌傪宍惉偡傞丅岤枌儗僕僗僩傪梡偄偰僐僱僋僞愙揰偺揹拻梡偺宆傪宍惉偡傞丅Ni揹拻偟偨屻丄岤枌儗僕僗僩丄Cu媇惖憌丄Cr/Ni庬憌偺弴偵彍嫀傪峴偆丅嵟屻偵Ni偺杊怘傪栚揑偲偟偨Au傔偭偒傪峴偆乮Fig.1乯丅
仭 Si婎斅忋偵僺僢僠80兪倣丄岤偝50兪倣偺僼僅乕僋僞僀僾偺僐僱僋僞抂巕傪惢嶌偡傞偙偲偑偱偒偨丅岤枌儗僕僗僩偱宍惉偟偨Ni揹拻梡宆偺傾僗儁僋僩斾偼嵟戝5偵払惉偟丄僥乕僷棪偼2亾偱偁偭偨丅儅僀僋儘僐僱僋僞偺嫮屌側浧崌偲惓妋側愙懕傪摼傞偨傔偵2抜奒偺僈僀僟儞僗傪嵦梡偟偨丅傑偨丄惢嶌偟偨僐僱僋僞抂巕扨懱傪浧崌偝偣丄愙怗掞峈傪應掕偟偨偲偙傠栺50倣W偺抣傪摼傞偙偲偑偱偒偨乮Fig.2丄Fig.3乯丅
丂

Table.1丂廬棃昳偲偺斾妑
丂
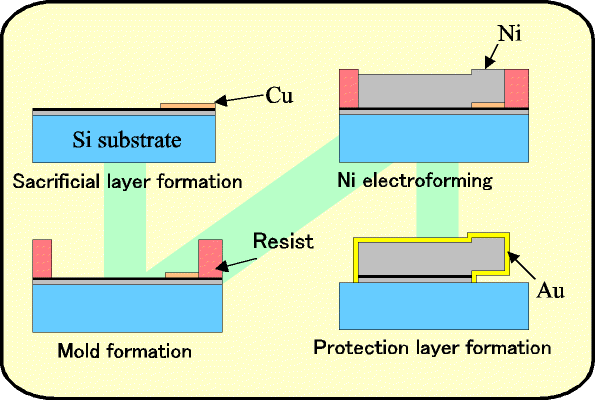
Fig.1丂惢嶌僾儘僙僗
丂
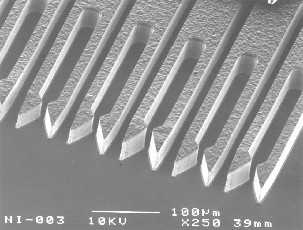 |
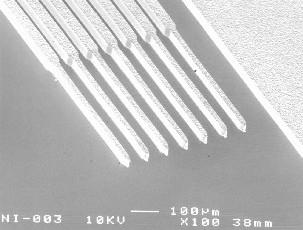 |
Fig.2丂惢嶌偟偨儅僀僋儘僐僱僋僞
丂
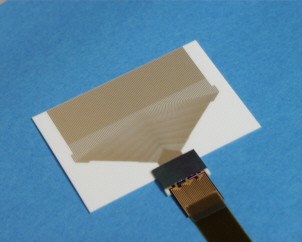
Fig.3丂幚憰偟偨儅僀僋儘僐僱僋僞
丂
丂