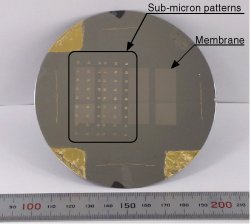 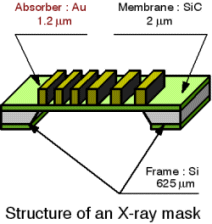 |
サブミクロンLIGAプロセス |
◆ シンクロトロン放射光リソグラフィを用い、サブミクロンサイズで高アスペクト比(高さ/幅)の超微細構造体の製作を可能にするサブミクロンLIGAプロセスの研究を進めている。
◆ サブミクロンLIGAプロセスを行う上で最も重要なことは、サブミクロンの解像度を持った高コントラスト(厚みのある吸収体を持った)のX線マスクの製作である。本研究では、厚膜レジストを用いた電子線直接描画とAu電鋳を組み合わせることによりこれを実現した(Fig.1)。
◆ サブミクロンの解像度を実現するために、試料のそりとSR光照射時の発熱について検討を行った。露光時のX線マスクとレジスト表面のギャップが狭いほど、フレネル回折の影響が少なくなり、高解像度を得ることができる。レジストの重合プロセスを最適化し残留応力のないレジストを形成することによって試料のそりをなくし、ギャップを狭く一定に保つことができた(Fig.2)。また、SR光照射時のX線マスク表面温度を計測した結果、数℃〜25℃の温度上昇が見られた(Fig.3)。エネルギー照射密度を下げる露光方法を検討し発熱によるパターンの歪みを低減させた。これらの検討結果を基に、最大アスペクト比75(幅0.2μm、高さ15μm)のサブミクロンNi構造体を製作することができた(Fig.4)。
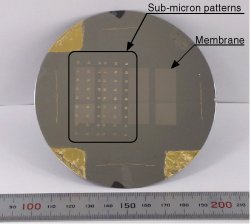 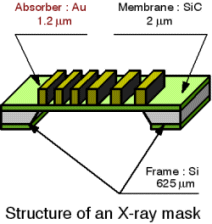 |
Fig.1 製作したX線マスク
 |
Fig.2 PMMAレジスト重合後の残留応力
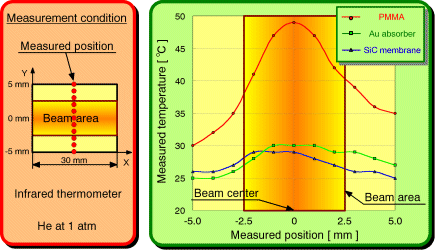 |
Fig.3 SR光照射中の各部の表面温度
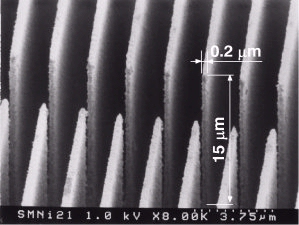 |
Fig.4 製作したサブミクロンNi構造体