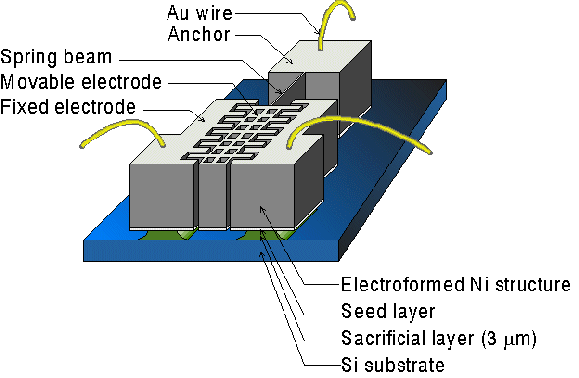
LIGA僾儘僙僗偵傛傞崅弌椡惷揹儅僀僋儘傾僋僠儏僄乕僞偺惢嶌 |
仧 棫懱揑側旝嵶峔憿懱傪惢嶌偡傞媄弍偲偟偰丄LIGA僾儘僙僗偑拲栚偝傟偰偄傞丅LIGA僾儘僙僗偲偼丄X慄儕僜僌儔僼傿乕丄揹婥傔偭偒丄儌乕儖僨傿儞僌傪慻傒崌傢偣偨媄弍偱偁傞丅敿摫懱惢嶌僾儘僙僗偵婎偯偔廬棃偺儅僀僋儘儅僔僯儞僌偱偼丄惢嶌偝傟傞峔憿懱偺崅偝偑悢兪倣乣悢廫兪倣偵尷傜傟傞偺偵懳偟丄LIGA僾儘僙僗偼崅偝悢昐兪倣埲忋丄傾僗儁僋僩斾悢廫埲忋偺3師尦揑側峔憿懱偺惢嶌偑壜擻偱偁傞丅杮尋媶偱偼彫宆僔儞僋儘僩儘儞曻幩岝(SR)憰抲AURORA傪梡偄偨LIGA僾儘僙僗媄弍偺尋媶奐敪傪栚揑偲偟丄惷揹儅僀僋儘傾僋僠儏僄乕僞偺惢嶌傪峴偭偨丅
仧 愝寁偟偨傾僋僠儏僄乕僞乕偺婎杮峔憿偼丄嵟壓憌偐傜弴偵Si婎斅丄SiO2丄Ni摫揹憌丄Ni峔憿懱偲側偭偰偄傞乮Fig.1乯丅Ni峔憿懱偼LIGA僾儘僙僗偵傛傝惢嶌偟丄屌掕揹嬌丄壜摦揹嬌丄抏惈椑丄媦傃傾儞僇乕偐傜側傞丅峔憿懱偺崅偝偼100兪倣偱偁傞丅壜摦揹嬌偼丄壓抧偺SiO2偺僄僢僠儞僌偵傛傝婎斅偐傜暘棧偝傟傞丅惢嶌寢壥傪Fig.2偵帵偡丅嵟彫慄暆2兪倣丄崅偝100兪倣丄嵟戝傾僗儁僋僩斾50偱偁傞丅
仧 崅傾僗儁僋僩斾旝嵶峔憿懱偵偲偭偰丄懁暻偺慹偝偼廳梫側梫慺偱偁傞丅揹拻偵傛偭偰摼傜傟偨Ni峔憿懱偺懁暻慹偝傪尨巕娫椡尠旝嬀乮AFM乯偵傛傝應掕傪峴偭偨丅Ni峔憿懱懁暻偺僾儘僼傽僀儖傪Fig.3偵帵偡丅悅捈曽岦偵尒傜傟傞峚偼丄X慄儅僗僋偺媧廂懱宍忬傪揮幨偟偨寢壥偱偁傞丅悈暯曽岦偺慹偝丄偮傑傝儅僗僋媧廂懱偺懁暻慹偝偼651値倣偱偁偭偨丅悅捈曽岦偺暯嬒慹偝偼23.1値倣偱偁偭偨丅偙傟偑X慄儕僜僌儔僼傿乕偺嵟廔巇忋偘慹偝偲側傞丅傑偨儅僀僋儘傾僋僠儏僄乕僞偺嬱摦幚尡傪峴偄丄儚僽儖儌乕僞乕丄孂帟揹嬌宆傾僋僠儏僄乕僞偱嬱摦偵惉岟偟偨丅
仧 惢嶌偟偨傾僋僠儏僄乕僞偺墳梡偲偟偰偼僴乕僪僨傿僗僋偺僿僢僪偺崅惛搙埵抲寛傔梡傾僋僠儏僄乕僞偑峫偊傜傟傞丅
丂
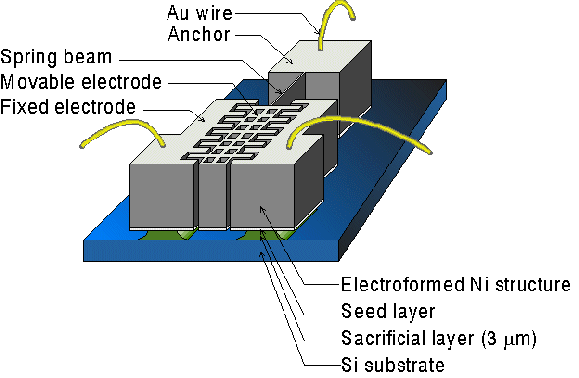
Fig.1丂婎杮峔憿
丂
丂
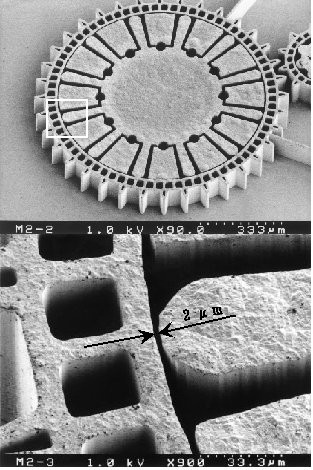
奼戝恾
捈宎1倣倣丄嵟彫僊儍僢僾2兪倣丄崅偝100兪倣丄
嵟戝傾僗儁僋僩斾50
Fig.2丂惢嶌偝傟偨儚僽儖儌乕僞乮揹巕尠旝嬀幨恀乯
丂
丂

悅捈曽岦偺暯嬒慹偝丗23.1値倣
悈暯曽岦偺暯嬒慹偝丗651値倣
Fig.3丂Ni峔憿懱偺昞柺慹偝
丂