X線吸収分光法
○ 概要
物質内の内殻準位とフェルミ準位以上の非占有状態のエネルギー差に相当するエネルギーを持った光(X線)をあてると、 内殻電子はその光のエネルギーを吸収し非占有状態に遷移します。 光の吸収率を光エネルギーを変えながら観測することで非占有状態の電子状態密度を調べることができます。

○元素ごとの情報がわかる
X線吸収分光では元素固有の吸収端にエネルギーを合わせることができます。 つまり、非占有状態にそれぞれの元素がどれだけ寄与しているかを個別に測定できます。 ここで、吸収端とは吸収スペクトルの中で急激に変化するエネルギーの部分を示し、フェルミ準位に対応します(上図参照)。
○測定原理
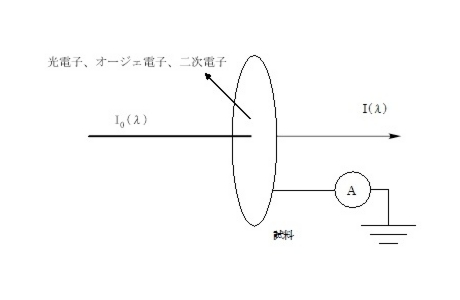
上図のように強度I0(λ)の単色X線(波長λ) を薄膜試料に入射し、試料を透過した後のX線の強度I(λ)を測定し、-log{I(λ)/I0 (λ)}をλに対してプロットしたものが X線吸収スペクトルになります。薄膜であればこのような測定が可能ですが、そうではない塊の試料のときは透過光を測定できません。 そこで、光電子やオージェ電子を利用します。入射したX線の吸収が大きければ大きいほど、 光電子やオージェ電子として放出される電子が多くなります。電子の量は、試料とアースの間に電流計をつないでおくことで測定します。 これを波長に対してプロットするとX線吸収スペクトルと等価なスペクトルを得られます。 (実際には、光電子やオージェ電子によって次々と励起された多数の「二次電子」を観測していることになります)