TiO₂に格⼦整合した⾼品質ルチル型GeₓSn₁₋ₓO₂ デバイスの動作実証 ―⾼耐圧パワーデバイスへの応⽤―
概要
⽴命館⼤学総合科学技術研究機構 ⾦⼦健太郎 教授・RARA フェロー/Patentix 株式会社・取締役CTO、京都⼤学⼤学院⼯学研究科 ⾼根倫史 博⼠後期課程学⽣、⽥中勝久 同教授、物質・材料研究機構 ⼤島孝仁 主任研究員、原⽥尚之 同独⽴研究者らの研究チームは、次世代パワーエレクトロニクス材料として注⽬されるルチル型酸化物半導体の1つであるルチル型(r-)GexSn1−xO2混晶の格⼦整合エピタキシーによる⾼品質化、および、その⾼品質なr-GexSn1−xO2(x=~0.53)薄膜を⽤いたショットキーバリアダイオード(SBD)の動作実証に成功しました。本成果は、極めて低い⽋陥密度が要求される⾼耐圧パワーデバイス材料として、ルチル型酸化物半導体が有⽤であることを⽰唆するものです。
r-GeO2 とr-SnO2 の混晶であるr-GexSn1−xO2 については、⾼範囲でのバンドギャップ変調、良好な電気伝導特性が報告されており、ヘテロ構造デバイスを含めた多様な応⽤が期待されます。本研究では、x を0.53 付近に調整してr-GexSn1−xO2 薄膜をr-TiO2 基板上に格⼦整合(格⼦整合エピタキシー)させることで、薄膜内の貫通転位密度を透過型電⼦顕微鏡の観察限界以下まで低減できることを明らかにしました。さらにr-TiO2 基板上に格⼦整合したr-GexSn1−xO2 薄膜を⽤いて作製したSBD は±5 V の電圧印加時に約105 程度の整流⽐を⽰し、今後のデバイス応⽤に有望であることが⽰唆されました。今後、パワーデバイスへの応⽤を⽬指した、ルチル型酸化物半導体に関する研究・開発のさらなる発展が期待されます。
本研究成果は、2024 年1 ⽉3 ⽇に応⽤物理学会の国際学術誌「Applied Physics Express」にオンライン掲載されました。

1.背景
ルチル型注1)(r-)GeO2 は、4.7 eV もの⼤きなバンドギャップを持ち、pn 両極性ドーピングの両⽴が可能であると理論的に予測されており、低損失かつ⾼耐圧なパワーデバイス注2)を実現する次世代半導体材料として注⽬されています。さらにr-GeO2 とr-SnO2 の混晶注3)であるr-GexSn1−xO2 についても、3.8−4.4 eV の範囲でのバンドギャップ変調、ならびに良好な電気伝導特性が報告されており、ヘテロ構造デバイスを含めた多様な応⽤が期待されます。⼀⽅で、本材料には解決しなければならない課題も多くあります。その1 つが転位注4)の低減です。現在、安価かつ⾼品質なr-GeO2、r-SnO2 の基板が市販されていないため、r-GeO2、r-SnO2、およびr-GexSn1−xO2 薄膜は同じルチル型構造を有するr-TiO2 基板上にヘテロエピタキシャル成⻑されることが⼀般的です。この場合、基板であるr-TiO2 と薄膜であるr-GeO2、r-SnO2、r-GexSn1−xO2 の格⼦定数が⼀致しないため(格⼦不整合)、基板・薄膜界⾯において転位が形成されます。その中でも、特にパワーデバイスの⾼耐圧動作時に悪影響を及ぼすとされる貫通転位注5)は、r-GeO2、r-SnO2、低x および⾼x のr-GexSn1−xO2 薄膜内において1010 cm−2 程度と⾼い密度になることが報告されており、⼤幅な低減が求められます。
2.研究⼿法・成果
本研究では、あるx においてr-GexSn1−xO2 とr-TiO2 の格⼦定数が⼀致することに着⽬しました。まず、第⼀原理計算によって算出した各x における格⼦定数から、およそx=0.53 においてr-GexSn1−xO2 とr-TiO2 のa軸⽅向の格⼦定数が⼀致することが予想されました。そこでミストCVD法注6)を⽤いて、x=0.53 付近のr-GexSn1−xO2 薄膜をr-TiO2(001)基板上に作製し、格⼦整合させること(格⼦整合エピタキシー)を⽬指しました。
まず、x=0.53 付近において異なる膜厚のr-GexSn1−xO2 薄膜をr-TiO2(001)基板上に作製し、⾛査型電⼦顕微鏡を⽤いて成⻑モードの観察を⾏いました。作製したr-GexSn1−xO2 薄膜(x=0.49−0.56)では、膜厚が48 nmから478nm の範囲で⼆次元的に成⻑が進⾏しており、表⾯の平坦性が⾮常に⾼いことが明らかになりました。これはフランク・ファンデルメルヴェ機構注7)による結晶成⻑を⽰すものであり、r-GexSn1−xO2 とr-TiO2 の格⼦不整合が⾮常に⼩さくなっていることを⽰唆しています。
膜厚が48 nm のr-Ge0.55Sn0.45O2 薄膜に対してX 線回折(XRD)測定と透過型電⼦顕微鏡観察(TEM)を⾏い、詳細な構造解析を実施しました。XRD 測定により、 r-Ge0.55Sn0.45O2薄膜が⾯内および⾯外⽅向に対して基板と同⼀⽅向に配向していること、r-Ge0.55Sn0.45O2薄膜内に明⽩な回転ドメインが存在しないこと、さらに逆格⼦マッピング測定より、r-Ge0.55Sn0.45O2薄膜がコヒーレント成⻑していることが明らかになりました。また、制限視野電⼦回折パターンから、同様にr-Ge0.55Sn0.45O2薄膜が⾯内および⾯外⽅向に対して基板と同⼀⽅向に配向していることが⾒いだされました。さらに、複数箇所におけるTEM の⾼分解能像では転位線が観察されませんでした。加えて界⾯における⾼⾓度散乱暗視野⾛査透過型電⼦顕微鏡(HAADF-STEM)像より、基板と薄膜のカチオン(Ti, Ge, Sn)位置が揃っていることが明らかになりました(図1)。これらはr-Ge0.55Sn0.45O2薄膜がr-TiO2 基板と格⼦整合し、薄膜内の転位密度が⼤幅に低減されたことを⽰すものです。
さらに、格⼦整合していると考えられる膜厚110 nm のr-TiO2(001)基板上r-Ge0.49Sn0.51O2 薄膜を⽤いて横型ショットキーバリアダイオード注8) (SBD)を作製しました。作製したSBDは±5Vの電圧印加時に約105程度の整流⽐を⽰しました(図2)。この結果は、r-TiO2 基板に格⼦整合したr-GexSn1−xO2 薄膜が今後のデバイス応⽤に有望であることを⽰唆するものです。
3.波及効果、今後の予定
電⼒変換損失が⼩さい⾼性能なパワー半導体の登場は、AI やスマート機器の普及にともなう電⼒消費の急増が著しい現代社会において⼤変重要です。本研究では、次世代パワーエレクトロニクス材料として注⽬されるルチル型酸化物半導体の1 つであるr-GexSn1−xO2 薄膜の⾼品質な結晶成⻑を実証するとともに、ルチル型酸化物半導体において初めてとなるデバイス動作を確認しました。本成果は、r-GexSn1−xO2 のみならず、r-GeO2や他のルチル型構造を有する酸化物半導体における研究開発に寄与できるとともに、将来的には持続可能で環境にやさしい社会インフラの実現に⼤きく貢献できると期待されます。今後は、r-GeO2 や他のルチル型酸化物半導体のデバイス化に向けた研究を推進する予定です。
4.研究プロジェクトについて
本研究の⼀部は、⽇本板硝⼦材料⼯学助成会、JSPS 科研費21H01811、⽂部科学省マテリアル先端リサーチインフラJPMXP1223NM5073 の助成のもとで実施されました。
用語説明
- 注1:ルチル型構造とは、正⽅晶系(空間群P42/mnm)に属し、陰イオンがゆがんだ六⽅最密充填構造をとり、その⼋⾯体位置(酸素6配位)に陽イオンが配置した結晶構造です。
- 注2:パワーデバイスとは、、主に電⼒変換を⾏う半導体デバイスのことを指します。パワーデバイスにおいて、低い損失および⾼い耐圧(強電界印加時のデバイスの壊れにくさ)が求められますが、これらはトレードオフの関係にあります。⼀⽅で、損失と耐圧はそれぞれ絶縁破壊電界値の−3 乗、3/2 乗に⽐例するため、絶縁破壊電界値が⼤きな材料ほど低損失かつ⾼耐圧のデバイスを実現できると⾔えます。ここで、絶縁破壊電界値とは、絶縁破壊を起こすことなく印加できる最⼤の電界で、バンドギャップのおよそ1.5~2.6 乗に⽐例する物質固有の値です。そのような背景から現在、きわめて⼤きなバンドギャップを有する超ワイドバンドギャップ半導体が新たなパワー半導体として注⽬を集めています。
- 注3:混晶とは、⼀般的に同じ結晶構造をもつ⼆種類以上の⾦属、半導体、絶縁体などが、ある⽐率で混じり合って⼀つの結晶を作り上げたものであり、固溶体とも呼ばれます。結晶構造が異なる固体同⼠であっても、⼀部の組成で混晶が形成される場合もあります。組成⽐や元素の種類を変えることにより、格⼦定数や電⼦構造(バンドギャップなど)を制御することができます。半導体デバイス分野では、13 族元素と15 族元素から成るIII-V 族半導体(GaAs 系や窒化物半導体)の混晶が発光デバイスや⾼周波デバイスなどに活⽤されています。
- 注4:転位とは、結晶中の格⼦⽋陥の⼀種で、原⼦が規則的に並んだ格⼦⾯が抜け落ちたような⽋陥を指します。線⽋陥とも呼ばれます。
- 注5:貫通転位とは、界⾯から薄膜表⾯まで伝搬する転位です。
- 注6:ミストCVD法とは、化学気相成⻑(chemical vapor deposition、CVD)法の⼀種であり、酸化物半導体薄膜の合成などに⽤いられている薄膜成⻑⼿法です。前駆体を溶かした原料溶液を霧(ミスト)化し、酸素や窒素などのキャリアガスを⽤いて基板上に搬送することで、薄膜を合成します。主な特徴としては、⽔や有機溶媒に溶ける物質であれば前駆体として⽤いることができること、⽐較的低温かつ⼤気開放下で合成できるため、準安定相の合成に向いていること、装置が簡便で安価であることなどが挙げられます。
- 注7:フランク・ファンデルメルヴェ機構とは、基板上に薄膜が成⻑する際の成⻑モードの1 つです。ある基板上に薄膜が成⻑する場合、基板および薄膜の表⾯⾃由エネルギーと界⾯⾃由エネルギーによって、成⻑する薄膜の形状が決定されます。基板と薄膜の格⼦不整合度が⼩さい場合、界⾯⾃由エネルギーが⼩さくなる(基板と薄膜の引⼒が強くなる)ため、薄膜が下地を完全に被覆するまで成⻑が進⾏せず、薄膜は2 次元状の層として成⻑します。このような成⻑モードがフランク・ファンデルメルヴェ機構と呼ばれます。
- 注8:ショットキーバリアダイオードとは、ある種の⾦属と半導体の接合によって⽣じるエネルギー障壁を利⽤したダイオードです。PN接合ダイオードと⽐較して、より⾼速のスイッチング動作が可能であるという特徴があります。
研究者のコメント
ルチル型酸化物半導体において初となるデバイスの動作実証を⾏えたことをうれしく思います。本系はまだまだ多くの課題があります。今後もひたむきに研究に取り組みたいと思います。
論文情報
- 論文名: Rutile-type GexSn1−xO2 alloy layers lattice-matched to TiO2 substrates for device applications(デバイス応⽤に向けたTiO2基板に格⼦整合したルチル型GexSn1−xO2混晶薄膜)
- 著者: Hitoshi Takane(京都⼤学⼤学院⼯学研究科), Takayoshi Oshima(国立研究開発法人 物質・材料研究機構), Takayuki Harada(国立研究開発法人 物質・材料研究機構), Kentaro Kaneko(⽴命館⼤学総合科学技術研究機構), and Katsuhisa Tanaka(京都⼤学⼤学院⼯学研究科)
- 発表雑誌: Applied Physics Express
- 掲載日: 2024年1⽉3⽇
- DOI: 10.35848/1882-0786/ad15f3
- 掲載URL: https://iopscience.iop.org/article/10.35848/1882-0786/ad15f3
参考図表
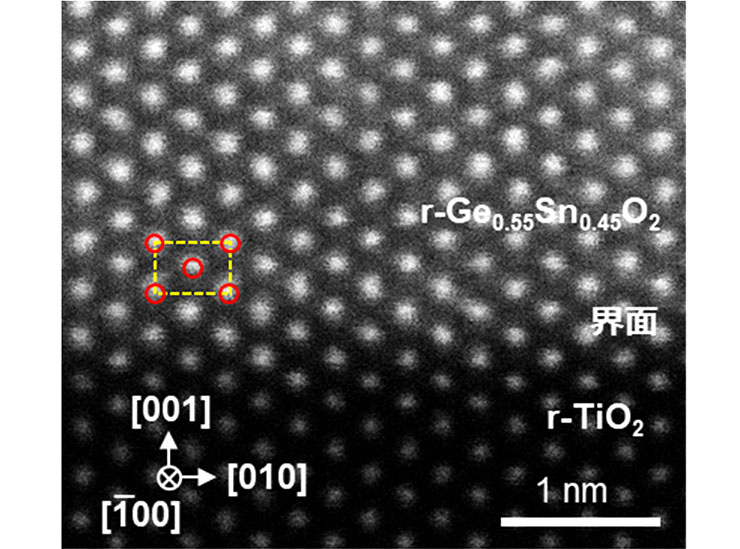 図1:r-Ge0.55Sn0.45O2薄膜/r-TiO2 基板界⾯のHAADF-STEM 像。⽩⾊の丸は、基板、薄膜それぞれを構成する陽イオン(Ti, Ge, Sn)に対応します。⾚丸はルチル型構造における陽イオンの配置を図⽰したものです。
図1:r-Ge0.55Sn0.45O2薄膜/r-TiO2 基板界⾯のHAADF-STEM 像。⽩⾊の丸は、基板、薄膜それぞれを構成する陽イオン(Ti, Ge, Sn)に対応します。⾚丸はルチル型構造における陽イオンの配置を図⽰したものです。
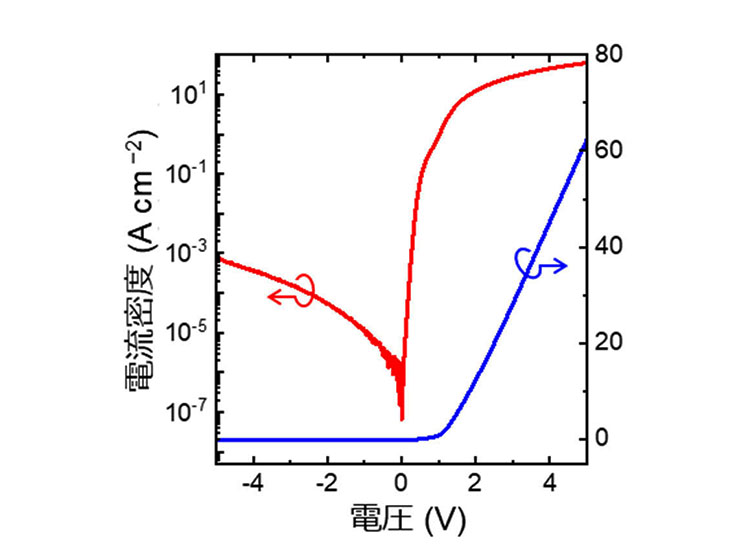 図2:r-TiO2(001)基板上r-Ge0.49Sn0.51O2 薄膜を⽤いて作製したショットキーバリアダイオードの電流密度-電圧特性
図2:r-TiO2(001)基板上r-Ge0.49Sn0.51O2 薄膜を⽤いて作製したショットキーバリアダイオードの電流密度-電圧特性










